패키징 공부 로드맵
패키징은 칩을 보호하고 전기적으로 연결하는 단계입니다. 최근에는 2.5D/3D, 팬아웃 등 고급 패키징이 중요해지면서 범위가 넓어졌습니다.
1단계: 기본 패키징 흐름
섹션 제목: “1단계: 기본 패키징 흐름”- 다이 분리(Dicing) → 접합(Bonding) → 몰딩(Molding) → 테스트
- 와이어 본딩 vs 플립칩의 차이 이해
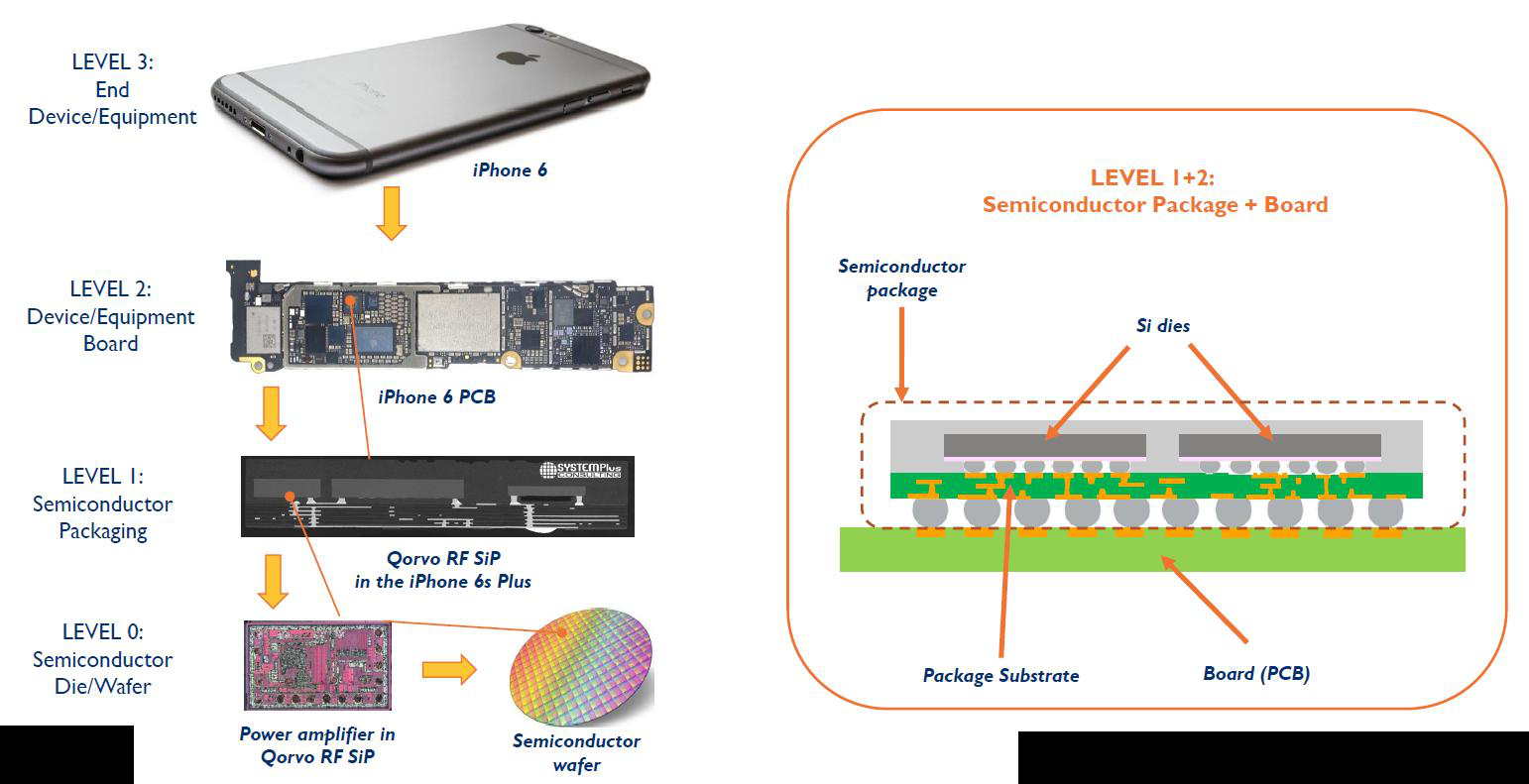
2단계: RDL/팬아웃 개념
섹션 제목: “2단계: RDL/팬아웃 개념”팬아웃 패키징은 웨이퍼 밖으로 배선을 확장해 I/O를 늘립니다. RDL(Redistribution Layer)의 설계와 공정이 핵심입니다.

3단계: 고급 패키징 구조
섹션 제목: “3단계: 고급 패키징 구조”- 2.5D(인터포저)와 3D(적층) 구조
- 열/신뢰성/변형(워페이지) 이슈
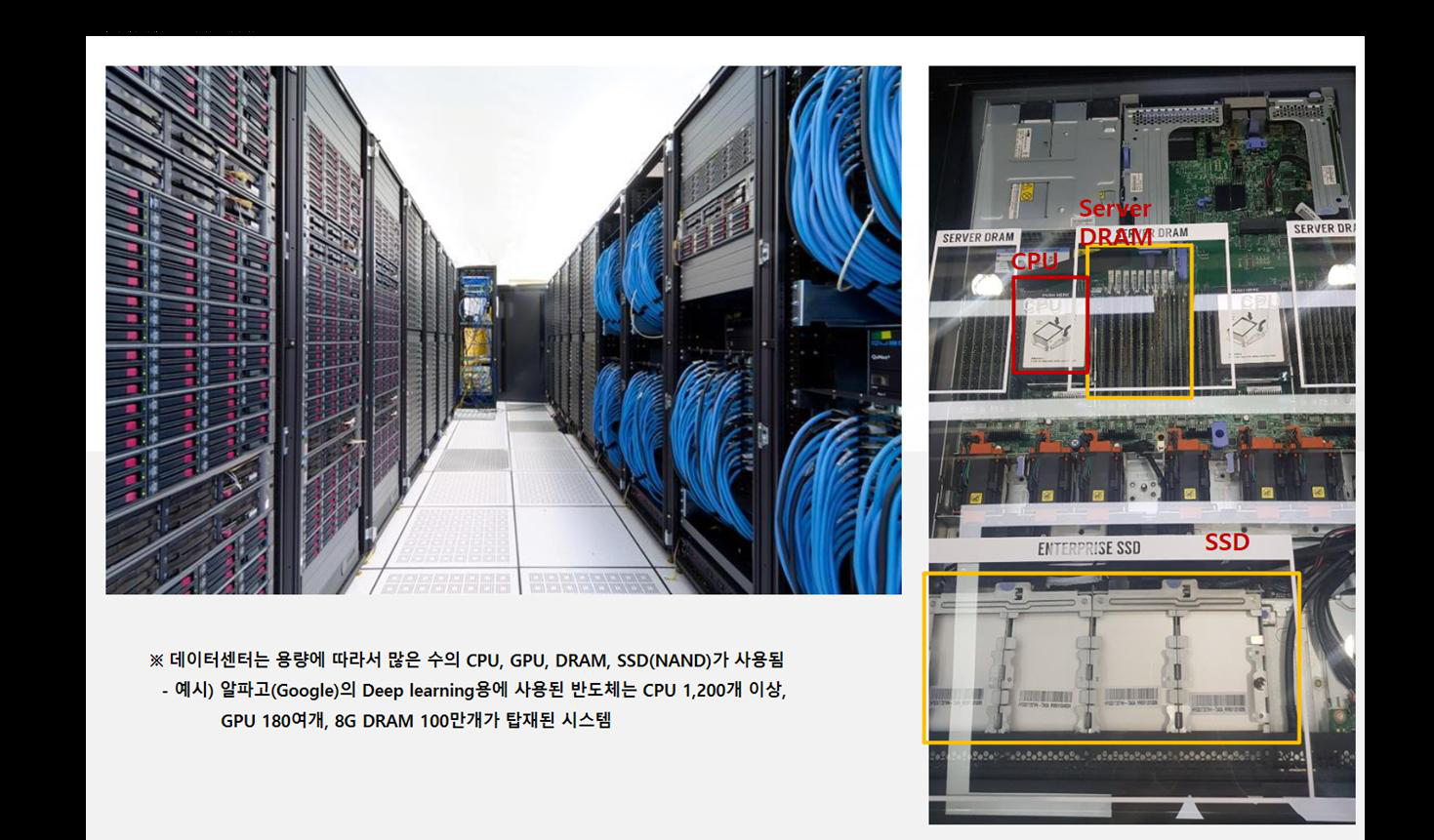
4단계: 테스트/신뢰성
섹션 제목: “4단계: 테스트/신뢰성”- 전기적 테스트(기능/파라미터)
- 신뢰성(열충격/습도/기계적 스트레스)

5단계: 시장 관점
섹션 제목: “5단계: 시장 관점”패키징은 OSAT와 파운드리 모두에서 전략적 분야입니다. 메모리/로직/AI 패키징 요구사항을 비교해 보면 경쟁 구도가 보입니다.
더 공부하기
섹션 제목: “더 공부하기”- TSMC: Advanced Packaging
https://www.tsmc.com/english/technology/advanced-packaging - Amkor: Advanced Packaging 사업 확대
https://investors.amkor.com/news-releases/news-release-details/amkor-technology-announces-plans-build-advanced-packaging