CMP
CMP(Chemical Mechanical Planarization)는 화학 반응과 기계적 연마로 표면을 평탄화하는 공정입니다.
다층 배선과 미세 패턴에서 평탄도 확보는 필수입니다.
CMP 공정의 핵심 구조
섹션 제목: “CMP 공정의 핵심 구조”CMP는 패드, 슬러리, 웨이퍼 캐리어가 맞물려 작동합니다.
이 세 요소의 조합이 제거율/결함/균일도를 결정합니다.
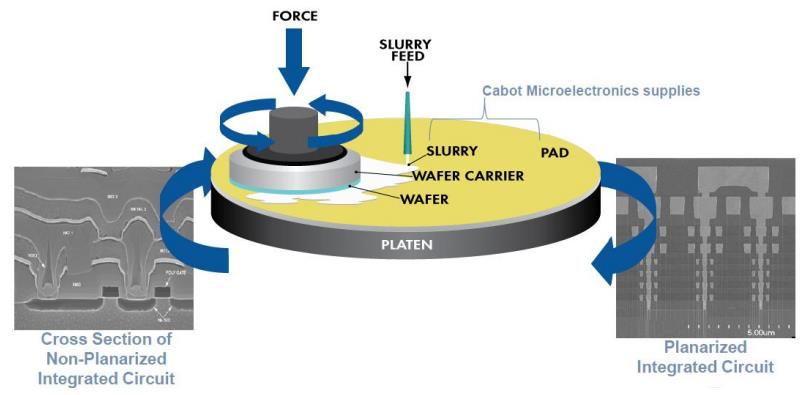
대표 결함: 디싱과 에로전
섹션 제목: “대표 결함: 디싱과 에로전”CMP는 지나치면 금속이 파이고(디싱),
절연막이 함께 깎이는 에로전이 발생합니다.
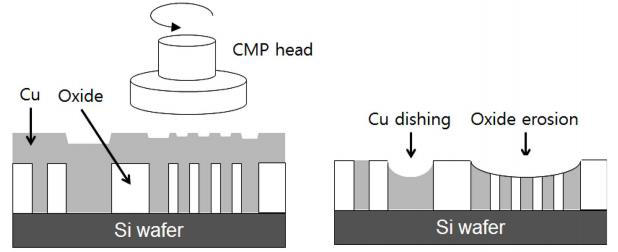
공정 제어 포인트
섹션 제목: “공정 제어 포인트”- 제거율(Removal Rate)
- 균일도(Within-wafer / Wafer-to-wafer)
- 슬러리 입자 크기/화학 성분
- 패드 컨디션/압력/속도
공정 설계 팁
섹션 제목: “공정 설계 팁”- 목표는 “가장 많이 깎는 것”이 아니라 균일하게 깎는 것
- 금속/절연막 조합에 따라 슬러리 화학 조합을 달리해야 함
자주 발생하는 문제
섹션 제목: “자주 발생하는 문제”- 과도 연마 → 금속 라인 손상
- 슬러리 관리 미흡 → 스크래치/결함 증가
- 기준 두께/측정 조건 불일치
더 공부하기
섹션 제목: “더 공부하기”- MIT: Chemical Mechanical Polishing (CMP) Lab
https://cmp.mit.edu/ - Applied Materials: CMP 솔루션
https://www.appliedmaterials.com/us/en/solutions/technologies/cmp.html