Cleaning
Cleaning은 웨이퍼 표면 오염을 제거해 이후 공정 품질을 보장하는 단계입니다.
잔류 오염이 남으면 패턴 붕괴, 누설 전류 증가, 결함 확대로 이어집니다.
세정 공정이 중요한 이유
섹션 제목: “세정 공정이 중요한 이유”세정은 “이전 공정의 흔적을 완전히 지우는 일”입니다.
노광/식각/증착/이온주입 이후 표면에 남는 PR 잔사, 금속 이온, 파티클은
다음 공정에서 결함 확률을 기하급수적으로 키우는 트리거가 됩니다.
제거해야 하는 오염원
섹션 제목: “제거해야 하는 오염원”세정은 단순히 “깨끗하게” 만드는 작업이 아니라, 오염원의 종류에 맞는 조합을 선택하는 과정입니다.
- 유기물 잔사: PR 잔사, 유기물 오염
- 금속 이온: 알칼리/전이금속 이온
- 파티클: 공정 중 발생한 미세 입자
- 표면 산화물: 네이티브 산화막/화학산화막

세정 방식의 구성
섹션 제목: “세정 방식의 구성”세정은 보통 습식/건식/증기 세정을 상황에 맞게 조합합니다.
하나의 방식만으로는 모든 오염원을 제거하기 어렵기 때문입니다.

대표 습식 세정 (RCA 계열)
섹션 제목: “대표 습식 세정 (RCA 계열)”- SC-1(NH₄OH/H₂O₂/H₂O): 파티클·유기물 제거에 강점
- SC-2(HCl/H₂O₂/H₂O): 금속 이온 제거에 강점
- DHF(희석 HF): 네이티브 산화막 제거(표면 수소 종단)
공정 목적(표면 상태, 후속 공정 민감도)에 따라 순서/농도/온도를 달리합니다.
건식·증기 세정
섹션 제목: “건식·증기 세정”- O₂/Ar 플라즈마: 유기 잔사 제거
- Ozone(오존)·Vapor Cleaning: 저손상/저수분 공정에 활용
습식에서 생기는 표면 장력 문제를 피하려는 경우 건식/증기가 유리합니다.
대표 공정 흐름(예시)
섹션 제목: “대표 공정 흐름(예시)”- Pre-clean: 표면 유기물/파티클 제거
- RCA 계열 세정: 금속·유기 복합 오염 제거
- DHF/BOE: 네이티브 산화막 제거 및 표면 종단
- DI Rinse & Dry: 재오염 방지, 워터마크 제거
세정 순서는 공정 목적(산화/확산/증착/노광)에 따라 달라집니다.
공정 설계의 4대 요소
섹션 제목: “공정 설계의 4대 요소”세정 공정은 다음 네 가지를 동시에 설계해야 합니다.
- 화학적 요소 (화학 반응)
- 온도
- 세정 순서
- 혼합 비율
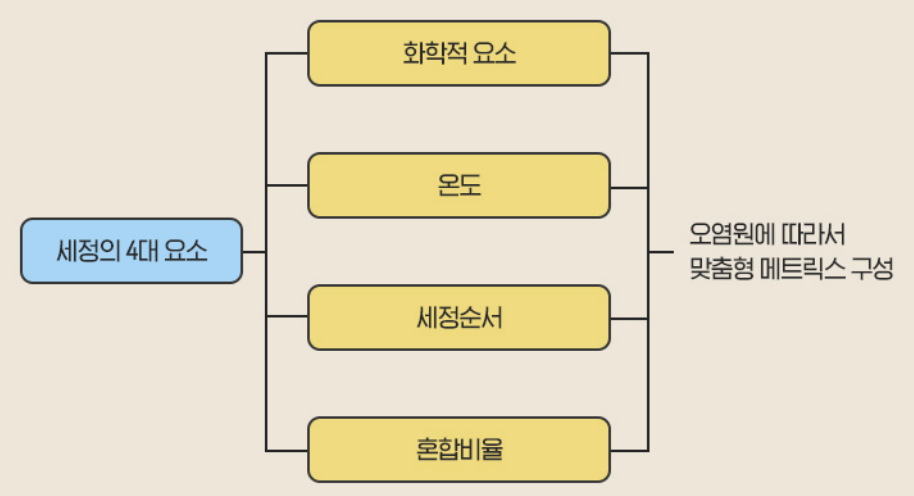
세정 실패가 만드는 결함
섹션 제목: “세정 실패가 만드는 결함”잔류 오염이 남으면 미세 구조에서 패턴 붕괴가 발생합니다.
특히 고종횡비 구조에서는 모세관 현상으로 인해 구조가 무너지는 경우가 흔합니다.
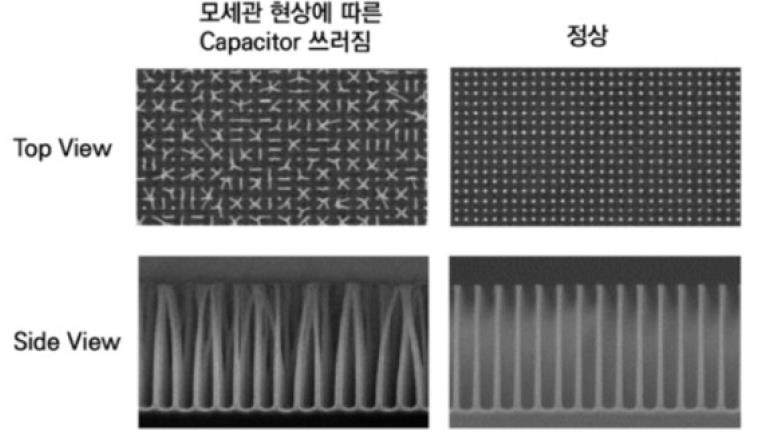
실무에서 자주 보는 체크 포인트
섹션 제목: “실무에서 자주 보는 체크 포인트”- 표면 거칠기/산화막 상태: 후속 공정 결함과 직결
- 재오염 방지: 세정 후 건조/보관 방식이 중요
- 재료 호환성: 금속/유전막 손상 여부 확인
- 메트릭: 파티클 카운트, 금속 잔류(ICP-MS), 표면 TOC
더 공부하기
섹션 제목: “더 공부하기”- MIT OCW 3.174: Wafer Cleaning (Lecture PDF)
https://ocw.mit.edu/courses/3-174-materials-processing-fall-2005/7a9e475c98ee75bd1dcbbcd6f3168fb3_3.4.1.pdf