Lithography
Lithography는 광원을 이용해 마스크 패턴을 레지스트(PR)에 전사하는 공정입니다.
결국 “패턴을 얼마나 정확히, 얼마나 균일하게, 얼마나 재현성 있게 그려내느냐”가 성패를 좌우합니다.
현대 리소그래피는 **광원을 마스크(레티클)에 통과시키고, 광학계로 축소·투영해 웨이퍼에 패턴을 찍는 ‘투영 시스템’**입니다.
광원 파장과 광학계 성능이 미세 패턴 한계를 결정합니다.
공정 흐름(작업 관점)
섹션 제목: “공정 흐름(작업 관점)”- PR 코팅 + 소프트 베이크
- 정렬(Alignment) + 노광(Exposure)
- PEB(후노광 베이크)
- 현상(Developer) → 패턴 형성
- 하드 베이크 + 검사
이 흐름 자체가 단순해 보여도, 각 단계의 온도·시간·표면 상태가 미세 패턴 품질을 크게 흔듭니다.
PR 코팅과 HMDS: 접착이 품질을 결정한다
섹션 제목: “PR 코팅과 HMDS: 접착이 품질을 결정한다”PR은 균일해야 하고, 기판 표면에 확실히 붙어 있어야 패턴 붕괴를 줄일 수 있습니다.
HMDS 처리는 표면 친수성을 소수성으로 바꿔 PR 접착력을 높이는 역할을 합니다.
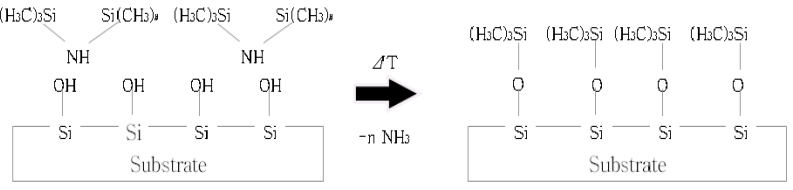
노광/현상: 패턴이 만들어지는 순간
섹션 제목: “노광/현상: 패턴이 만들어지는 순간”마스크를 통과한 빛이 PR에 반응을 일으키면, 현상액이 특정 영역만 제거합니다.
이 과정이 정확해야 CD(선폭)와 패턴 윤곽이 안정적으로 유지됩니다.
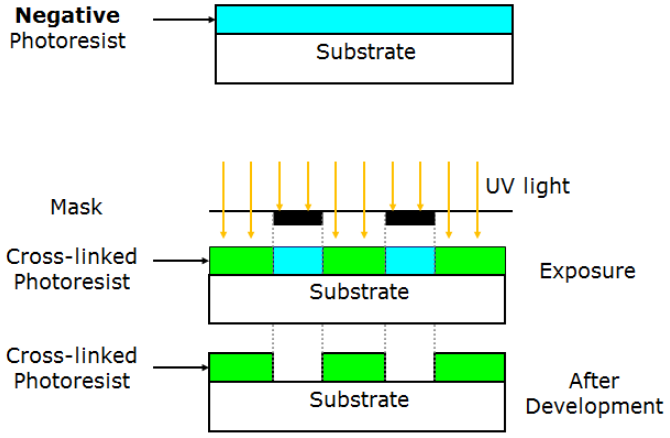
스테퍼 vs 스캐너: 장비가 품질과 생산성을 가른다
섹션 제목: “스테퍼 vs 스캐너: 장비가 품질과 생산성을 가른다”스테퍼는 한 번에 한 필드씩, 스캐너는 슬릿 방식으로 스캔해 노광합니다.
초미세 공정에서는 스캐너가 왜곡/수차 관리에 유리합니다.
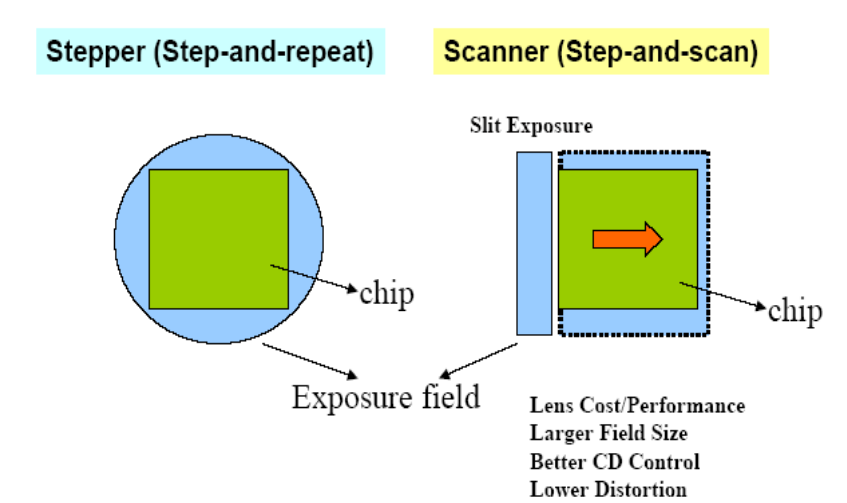
해상도(Resolution)와 DOF는 항상 트레이드오프
섹션 제목: “해상도(Resolution)와 DOF는 항상 트레이드오프”NA를 키우면 해상도는 좋아지지만 DOF가 얕아지는 문제가 생깁니다.
즉, 더 미세한 패턴을 얻으려면 공정 안정성을 동시에 확보해야 합니다.

EUV와 High-NA: 초미세 공정의 핵심
섹션 제목: “EUV와 High-NA: 초미세 공정의 핵심”EUV는 파장이 짧아 초미세 패턴에 유리하지만, 광학계/마스크 구조가 복잡합니다.
High-NA EUV는 더 높은 해상도를 제공하지만 공정 난이도와 비용이 증가합니다.
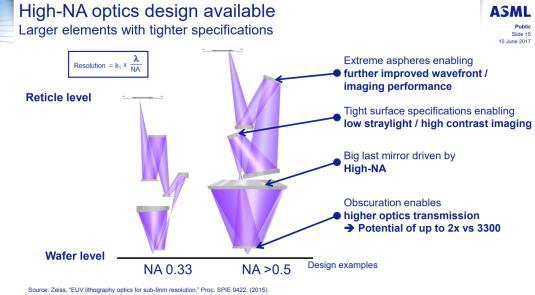
EUV는 13.5nm 파장을 사용하며, DUV(예: ArF 193nm) 대비 훨씬 작은 패턴 인쇄가 가능합니다.
EUV에서는 투과 렌즈 대신 다층 미러 기반 광학계가 쓰입니다.
정렬(Overlay)과 CDU
섹션 제목: “정렬(Overlay)과 CDU”- Overlay: 이전 층과의 정렬 오차
- CDU(Critical Dimension Uniformity): 칩 전 영역에서 선폭 균일성
미세 공정에서는 Overlay와 CDU가 수율과 직결됩니다.
마스크 구조: EUV는 반사형, DUV는 투과형
섹션 제목: “마스크 구조: EUV는 반사형, DUV는 투과형”EUV는 반사형 마스크 구조를 사용하며, 다층 박막과 흡수체 구조가 핵심입니다.
마스크 구조가 바뀌면 오염/결함 관리 방식도 완전히 달라집니다.
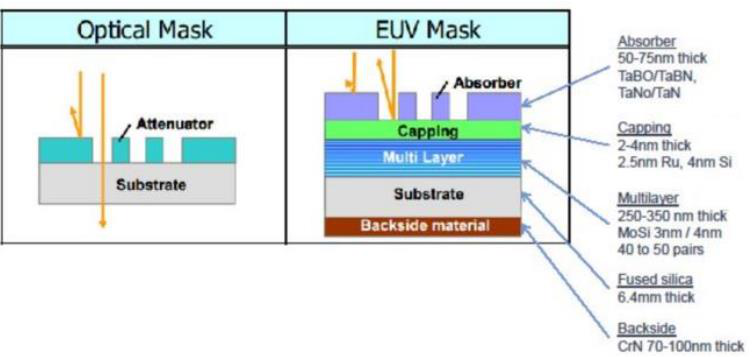
실전에서 자주 발생하는 문제
섹션 제목: “실전에서 자주 발생하는 문제”- PR 두께/베이크 불안정 → 패턴 붕괴
- 오버레이 불량 → 층간 단락/개방
- EUV 마스크 오염 → 결함 급증
더 공부하기
섹션 제목: “더 공부하기”- ASML: EUV Lithography
https://www.asml.com/en/technology/all-about-euv-lithography - ASML: High-NA EUV Lithography
https://www.asml.com/en/technology/all-about-euv-lithography/high-na-euv-lithography