Etch
Etch는 마스크로 보호된 영역을 남기고, 필요한 부분만 제거해 패턴을 전사하는 공정입니다.
식각은 단순히 재료를 “깎는” 단계가 아니라, 방향성(수직성), 선택비, 표면 손상을 함께 관리해야 하는 정밀 공정입니다.
산업 현장에서는 대부분 건식(플라즈마) 식각을 사용하며, 미세 패턴 형성과 공정 윈도 확보에 유리합니다.
습식 식각은 등방성 특성 때문에 단순 패턴/대면적 공정에 쓰이는 경우가 많습니다.
공정이 결정하는 것
섹션 제목: “공정이 결정하는 것”- 형상: 식각 방향성에 따라 측벽 프로파일이 바뀜
- 선택비: 마스크/기판/하부막이 얼마나 버티는지
- 결함: 잔사, 과식각, 미세 손상 → 이후 공정 수율에 직결
공정 흐름(실제 작업 관점)
섹션 제목: “공정 흐름(실제 작업 관점)”- 마스크 준비(PR 또는 하드마스크)
- 플라즈마/화학 반응 환경 구성
- 목표 재료 식각(엔드포인트 감지 포함)
- 잔사 제거/스트립
- 세정 및 검사
플라즈마 식각의 핵심 원리
섹션 제목: “플라즈마 식각의 핵심 원리”플라즈마는 전자 가열 → 이온화 → 이온/라디칼 생성의 순서로 만들어집니다.
이 과정에서 생성된 이온/라디칼이 표면과 반응하거나 물리적 충돌을 일으켜 식각을 진행합니다.
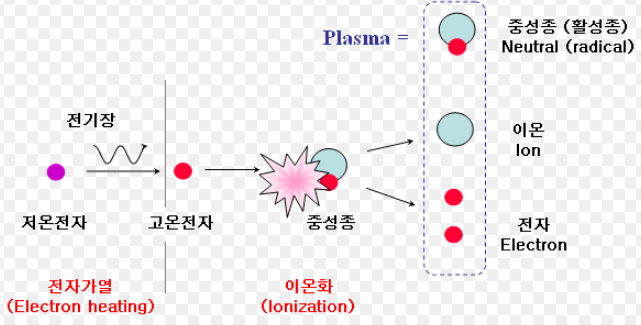
물리적 스퍼터링과 이온 가속
섹션 제목: “물리적 스퍼터링과 이온 가속”플라즈마 내 이온이 가속되어 표면을 때리면 물리적 스퍼터링이 발생합니다.
이때 DC 바이어스가 형성되어 웨이퍼 표면 방향으로 이온이 끌려오며, 방향성이 강화됩니다.
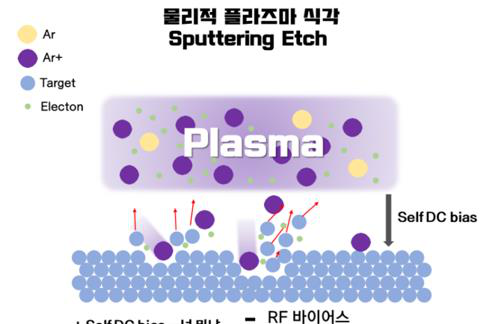
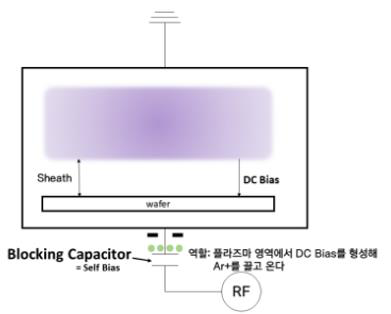
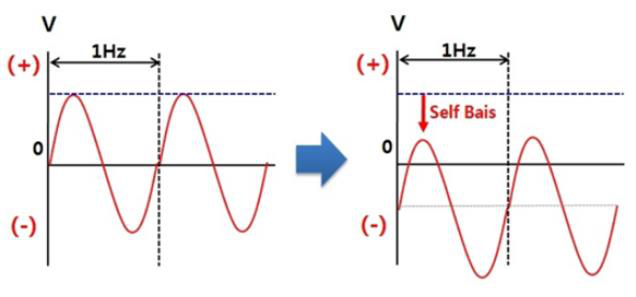
방향성(Anisotropy)과 미세패턴
섹션 제목: “방향성(Anisotropy)과 미세패턴”미세 패턴에서는 측벽 직각성이 가장 중요합니다.
이때 가스 조성, 이온 에너지, 압력, RF 파워를 조절해 수직 식각을 확보합니다.
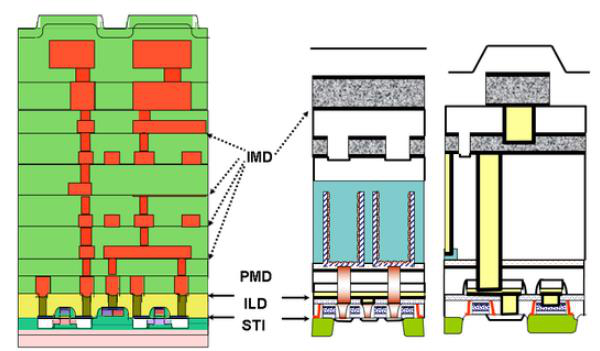
재료 선택비와 마스크 소모
섹션 제목: “재료 선택비와 마스크 소모”식각은 목표막만 제거해야 하므로 선택비가 핵심입니다.
선택비가 낮으면 마스크가 빨리 소모되고, 과식각 위험이 증가합니다.
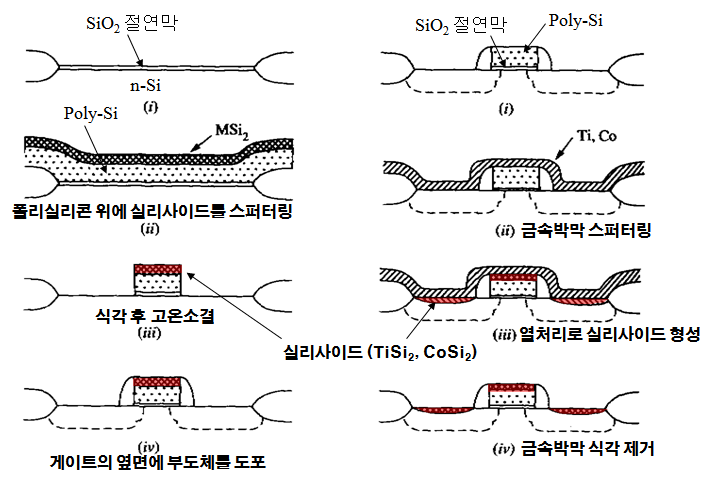
공정 실패 패턴(실전 관점)
섹션 제목: “공정 실패 패턴(실전 관점)”- 과식각 → 기판 손상, 누설 증가
- 선택비 관리 실패 → 마스크 과소모
- 잔사 제거 미흡 → 이후 공정 결함 확대
공정 이해를 돕는 예시
섹션 제목: “공정 이해를 돕는 예시”식각/패터닝 후 공정은 후속 금속/접합 단계와 바로 연결됩니다.
식각 프로파일이 조금만 틀어져도 접촉 불량이나 배선 단락으로 이어질 수 있습니다.
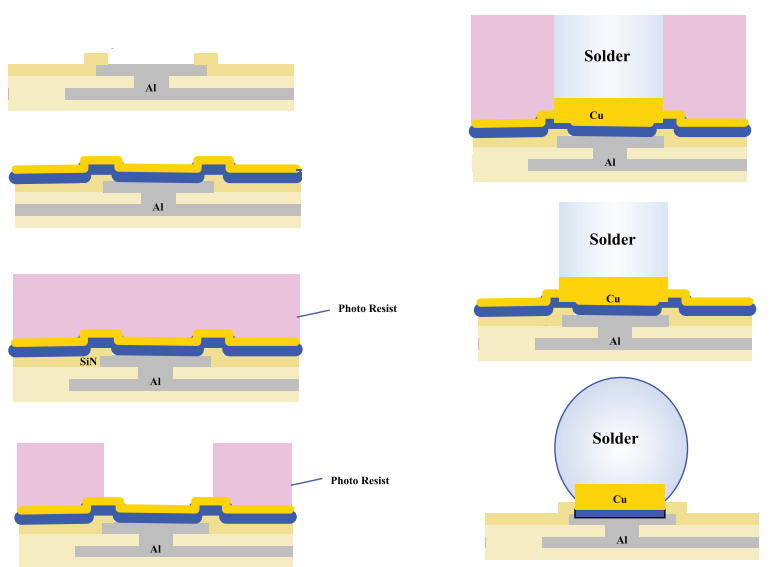
건식 vs 습식 식각
섹션 제목: “건식 vs 습식 식각”- 건식(플라즈마): 방향성 우수, 미세 패턴에 유리
- 습식: 등방성(undercut 발생 가능), 대면적/단순 형상에 유리
미세 공정에서는 대부분 건식 식각을 사용하며, 플라즈마 조건이 CD와 프로파일을 좌우합니다.
최신 식각 흐름: RIE → ALE
섹션 제목: “최신 식각 흐름: RIE → ALE”초미세 구조에서는 **원자층 단위 제어(ALE, Atomic Layer Etch)**가 중요해집니다.
ALE는 한 사이클마다 극소량만 제거해 프로파일 제어와 손상 저감에 유리합니다.
더 공부하기
섹션 제목: “더 공부하기”- Lam Research: Etch 공정 개요
https://www.lamresearch.com/technology/etch/ - Lam Research: Atomic Layer Etch(ALE)
https://www.lamresearch.com/technology/atomic-layer-etch-ale/