Ion Implantation
Ion Implantation은 이온을 가속해 웨이퍼에 주입하여 도핑 프로파일을 만드는 공정입니다.
주입 에너지·도즈·각도에 따라 깊이와 농도 분포가 결정됩니다.
공정 흐름(요약)
섹션 제목: “공정 흐름(요약)”- 이온 소스에서 플라즈마 생성
- 질량 분리/가속으로 원하는 이온만 추출
- 주입/스캔으로 웨이퍼 전면에 균일 도핑
- 어닐로 손상 복구 및 활성화
이온 주입의 핵심 원리
섹션 제목: “이온 주입의 핵심 원리”도핑 프로파일은 입사 이온의 에너지와 충돌로 형성됩니다.
깊이/분포는 단순히 “많이 넣는 것”이 아니라 정밀한 프로파일 제어가 핵심입니다.

플라즈마 생성과 이온화
섹션 제목: “플라즈마 생성과 이온화”이온 주입은 플라즈마에서 이온을 생성한 뒤 가속해 진행됩니다.
전자 가열 → 이온화 과정이 안정적이어야 주입 균일도가 확보됩니다.
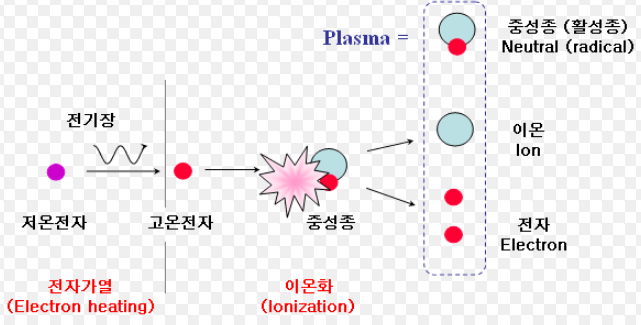
주입 에너지와 각도
섹션 제목: “주입 에너지와 각도”주입 에너지가 높을수록 주입 깊이가 깊어지며,
각도에 따라 채널링/스퍼터링 리스크가 달라집니다.
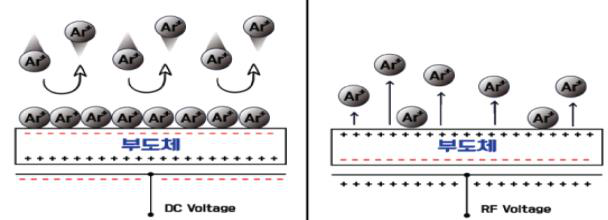
채널링(Channeling) 방지
섹션 제목: “채널링(Channeling) 방지”결정 방향과 평행하게 주입되면 이온이 깊게 침투하는 채널링이 발생합니다.
그래서 틸트/회전 각도를 조절해 채널링을 줄입니다.
표면 손상과 스퍼터링
섹션 제목: “표면 손상과 스퍼터링”이온 충돌은 표면 손상과 스퍼터링을 동반합니다.
따라서 주입 후 어닐(Anneal) 공정으로 손상을 복구해야 합니다.
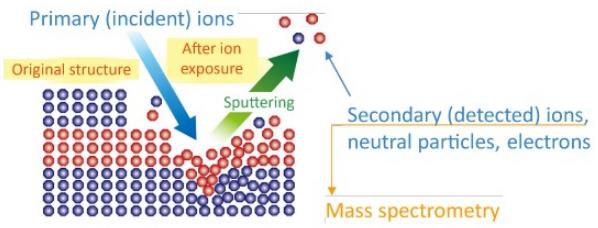
전기적 특성 형성
섹션 제목: “전기적 특성 형성”도핑은 p-n 접합에서 농도 구배와 전기장을 형성합니다.
이 분포가 소자의 동작 전류와 누설에 직접 영향을 줍니다.

자주 발생하는 문제
섹션 제목: “자주 발생하는 문제”- 주입 균일도 미흡 → 소자 간 특성 편차
- 채널링 과다 → 비정상 깊이 형성
- 어닐 조건 부족 → 결함 잔류
공정 팁
섹션 제목: “공정 팁”- 채널링 방지를 위해 보통 틸트/트위스트 각도를 부여합니다.
- 초박막/미세 소자에서는 도핑 농도뿐 아니라 프로파일 꼬리가 성능을 좌우합니다.
- 주입 손상은 후공정(확산/산화/금속)에서 증폭될 수 있어 사전 설계가 필요합니다.
더 공부하기
섹션 제목: “더 공부하기”- MIT OCW 3.174: Ion Implantation (Lecture PDF)
https://ocw.mit.edu/courses/3-174-materials-processing-fall-2005/1.6.2Ion_Implantation.pdf